■ 플라즈마 종류와 응용
[플라즈마 발생 방식에 따른 분류]
1) DC 플라즈마 : 두 개의 평행 판 전극 사이에서 생성
- Anode와 Cathode가 있고 그 사이에 가스가 있어서 양 극 사이에 가해지는 전압으로 발생되는 플라즈마
- Glow Discharge(발광 방전) : 음극(Cathode) 쪽 Sheath에만 나타남.
- 플라즈마가 Sheath 영역에서는 전기적으로 양성이므로 Cathode는 음극의 역할.
- Sheath Voltage = 음극 근처 강한 전압으로 이온이 끌려오면서 폭격, 양극 근처에서는 X
- Sputtering이나 Etching 공정에 사용
- 한 전극이 부도체(식각재료, 증착 기판, Sputter Target)이면
부도체 전극이 Charge-up 되어 방전전압을 상쇄, 방전유지불가능 -> 교류 방전이 필요

* 전자는 쉽게 양극으로 흘러들어 가게 되고, 이온은 질량이 상대적으로 무거워서 음극으로 쉽게 흘러들어 가지 않음.
=> 따라서 음극 양극이 대칭적이지 않음. 음극 근방에서 형성된 전위 차가 커서 큰 전기장이 형성 -> 이온이 가속되게 되는데 이때 음극에 형성된 전위분포를 음극 전압강하라고 한다. (=음극에 형성된 Sheath 현상)
=> 플라즈마 반응기 내에서 가장 전기장의 세기가 강한 곳으로 전기장의 방향은 음극판을 향한다. 이 전기장으로부터 가속된 높은 에너지를 가진 이온이 음극 판에 입사하고, 음극 표면과 충돌해서 방출되는 전자(=이차전자)들은 이 전기장으로부터 가속되면서 Chamber 중심부로.. 이들은 다시 공간 내 이온화 반응에 기여함으로써 플라즈마를 유지하는데 매우 중요한 역할.
* DC Power supply는 arch suprresion 기능이 요구됨.
* DC Plasma heating : secondary electron emission
2) RF 플라즈마
- +, -가 주기적으로 변화(가스 충돌 유발)하는 RF의 특성을 이용
- 부도체의 Etching이나 Sputtering에 이용
- DC 플라즈마에 비해 10~100배 정도 이온화가 빠르다.
- RF 방전에서 전극이 도체가 아니어도 플라즈마 발생이 가능
- 두 개의 평행 판 내에서 전극의 크기(전압)에 의해 전기장이 형성되면 챔버내 매질(가스종류)과 챔버의 압력이 운전에 중요한 변수로 작용.
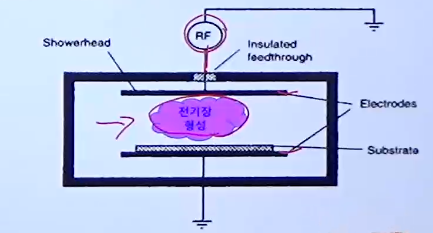
[플라즈마 발생 Source에 따른 분류]
1) RIE (Reactive Ion Etching)
- 두개의 평행 평판형 전극을 사용하는 형태의 Plasma source
- RF 전압이 가해지는 쪽에 W/F가 놓여지는 경우 : RIE
- RIE에서는 DC Negative Self Bias Voltage 형성 -> 이방성 식각(이온 폭격)
- 접지전극에 W/F가 높여지는 경우 : Plasma etching (Radical 많이 발생) => 등방성 식각 현상

2) MERIE (Magnetically Enhanced RIE)
- RIE 방식의 변형으로 Plasma 공간에 자기장을 인가
- Ion 발생 확률을 높여 고밀도 Plasma 상태에서 Etching 하는 장치
- RIE 보다 이온화 효율이 높음
- 저압 공정 가능, E/R이 향상
3) ECR(Electron Cyclotron Resonance)
- Microwave를 입사시켜 공명을 발생시키며 전자의 운동을 강화시켜 중성입자들과 충돌하여 이온화
4) TCP (Transformer Coupled Plasma)
- RF Coill을 사용하는 형태의 Plasma source
- RF Coil이 Chamber의 상부에만 있다.
- 자계(수직방향)+전계(수평방향)형성으로 전자의 회전 및 가속으로 이온화 플라즈마 발생시킴
- 구조 간단, Uniform/고밀도 Plasma
- Plasma 밀도와 이온 에너지를 개별적으로 조절 가능
- 높은 전자 온도, Film Damage

5) ICP (Indctively Coupled Plasma)
- RF Coil을 사용하는 형태의 Plasma Source
- RF Coil이 Chamber의 측면에 감긴다. (Coil이 감긴 형태를 상부에서 보면 원 형태)
- 고밀도 Plasma, 저압 안정
- Cylindrical type, Planer type
- ★Plasma 밀도(라디칼)와 이온 에너지(이온)를 개별적으로 조절 가능 => 등방성, 이방성 식각 개별적 조절
- 높은 전자 온도, Film Damage
6) HDP(High Denity Plasma)
- ECR, TCP, ICP 등이 고밀도 Plasma ( Plasma Density가 10^11 이상)
- 플라즈마 생성과 이온에너지를 조절하는 부위가 서로 독립적으로 Control 되는 특징
- 수-수십mTorr 정도의 Low Pressure 대역에서 Plasma를 유지
- Process window가 좁고 electron energy가 높아 process control을 어렵게 하는 단점
* CCP
CCP를 이용한 건식식각에도 미세공정에 한계
집적도가 증가하면서 이를 구현하기 위해 보다 수직으로 입사해야 하며 반응성 이온의 양이 많아야 한다는 점

교류(RF) 플라즈마도 2개의 전극판 사이에 플라즈마를 형성하는 용량성 이면 용량성 플라즈마(CCP : Capacitively Coupled Plasma), 플라즈마 외곽으로 코일을 감아 놓은 구조인 유도성이면 유도성 플라즈마(ICP : Inductively Coupled Plasma)
[플라즈마의 응용]
- Dry Etching, Ashing
- PECVD, HDPCVD
- Sputtering
- Plasma Immersed Ion Implantation
- Plasma Cleaning
'반도체 공부' 카테고리의 다른 글
| [Etch 공정 심화 5] Etch 장비, 불량 사례 (0) | 2021.03.28 |
|---|---|
| [Etch 공정 심화 4] Dry Etch (0) | 2021.03.27 |
| [Etch 공정 심화 2] Etch 공정의 목적과 장단점 (Feat.플라즈마) (0) | 2021.03.26 |
| [Etch 공정 심화 1] Etch 공정의 정의와 용어 (0) | 2021.03.12 |
| [Photo 공정 심화3] (0) | 2021.02.24 |



