Etch 공정의 정의와 용어
1. 식각 공정의 정의
감광막 현상 공정이 끝난 후 감광막 밑에 길러진 산화막 혹은 박막들을 공정 목적에 따라 부분적/전체적으로 제거하는 기술
- 목적 : 노광 공정에 의해 감광제에 패턴이 형성된 다음, 감광제의 패턴을 실제 박막에 옮기는 과정
- 반도체 소자 제작에서의 불필요한 부분을 제거하는 공정
· 반도체 공정에서 집적도를 결정하는 것
· 선택적 식각과 비선택적 식각
2. 식각 관련 용어
1) Etch Bias(Skew)
= Wb(Photo Dimension=ADI CD) - Wa(Etch Dimension=ACI CD)
- Reticle CD
- ADI CD : After Development Inspection
- ACI CD : After Cleaning Inspection (에치 후)
* Etch Skew : ADI - ACI
* Etch Bias : Reticle - ADI CD
- Photo에 의하여 형성된 패턴이 식각과정을 거치면서 변화 되는 것 -> 패턴을 설계 할 때 반드시 고려해야 함.
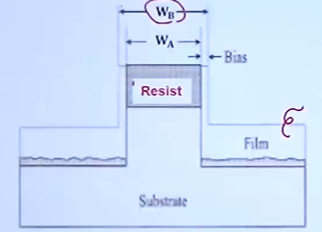
2) Over Etch & Undercut
- Over Etch : 식각이 충분히 진행 되어 원하는 두께나 깊이를 과하게 넘어선 상태 (조금은 원래 해줌)
- Undercut : Wet etching에서는 피할 수 없이 나타나며, Open 된 영역보다 크게 식각되는 현상 (Lateral etch/side etch)
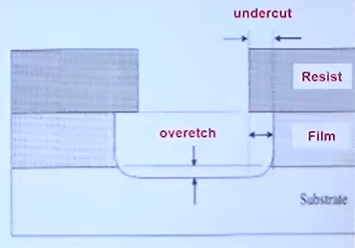
3) 식각률 (Etch Rate= ER)
- 식각 시간 동안 제거된 대상물질의 두께
- ER = △d/t (A/min)
4) 선택비 (Selectivity) ★ 에치에서 제일 중요!
- 다른 물질들간의 식각률 차이의 비율
- 패턴되는 식각에서 매우 중요한 변수 (미세화 공정에서 100:1, 200:1)
- 감광막과 그 물질과의 식각율 비율


5) 식각 균일도 (Etch Uniformity) ★ 수율에서 굉장히 중요!
- 식각된 두께 재현성 : Wafer 내, Wafer 간 9 points 정도에서 시각 전, 후의 두께 측정
- 표준 편차로 공정 재현성 판단
* 바깥쪽, 센터 식각균일도가 틀린 이유?
- 웨이퍼에 온도 차이로 인해 Etch rate가 달라져서 식각률이 달라지면 CD 차이 -> 수율에 영향을 준다.
6) Aspect Ratio
- A.R = Height / Width
- 숫자가 크면 좁고 깊다 -> 막질 채우기 힘들어진다.. 파는것도 힘들다 (Etch, Depo에서 모두 중요)
* Side Step coverage = 위/옆
* Bottom Step coverage = 위/바닥
7) ★ Loading Effect
① Micro loading effect
- 아주 미세한 패턴에 대해서 식각후 반응 생성물의 배출이 원활하지 않아 넓은 패턴에 비해 식각이 잘 되지 않는 현상
- 패턴이 미세할 경우, 식각되는 깊이가 깊어질수록 자주 발생
- 해결책 : 식각 공정시 압력을 낮게 하거나(MFP↑), 가스의 유속을 빠르게 하는 방법 => 레시피 조절!!
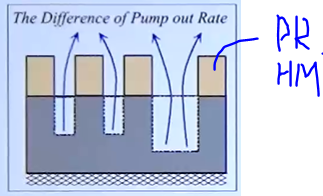
② Macro loading effect
- 식각 면적이 너무 넓어 식각제의 공급이 원활하지 않게 되면 넓은 면적의 식각이 잘 일어나지 않게 되어 식각되는 깊이가 달라지게 되는 현상
- 패턴의 밀도 및 식각 영역 등을 고려하여 공정 조건을 최적화
- 해결책 : 넓은 영역에 대하여 더미 (Dummy) 패턴을 삽입하여 조밀하게 형성

8) ★ EPD (End Point Detection)
- 반도체 제조 공정 중 식각 공정에서 원하는 막질이 제거되었는지 알아보는 방법 (CMP에서도 사용?)
- 분류 : OES방식(제일 많이 씀), 간섭현상을 이용하는 방식, RF generator 시스템에서 발생하는 RF 파의 전압과 전류를 모니터링하는 방법
- 모든 원자는 고유의 emission 파장을 가짐.
- 다른 재료가 etch 될 때 Plasma 색이 변함
- Optical sensor로 변화를 감지하고 Etch 공정의 Endpoint를 알 수 있음.
* OES(Optical Emission Spectroscopy) : Plasma등의 광원으로부터 발생되는 에너지에 의해 여기된 원자 (들뜬 원자)가 기저 상태로 이동하는 빛을 관측하여 빛의 파장으로부터 원소의 정성을, 또는 빛의 강도(intensity)로 원소를 정량하는 방법이다.
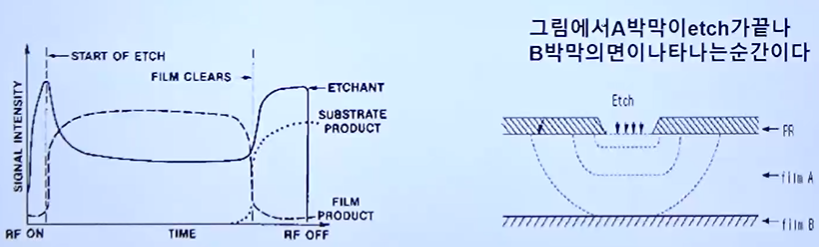
* EPD 외에 Time Etch 라는 방법도 있음?
'반도체 공부' 카테고리의 다른 글
| [Etch 공정 심화 3] 플라즈마 종류와 응용(Feat.Dry Etch) (0) | 2021.03.27 |
|---|---|
| [Etch 공정 심화 2] Etch 공정의 목적과 장단점 (Feat.플라즈마) (0) | 2021.03.26 |
| [Photo 공정 심화3] (0) | 2021.02.24 |
| [Photo 공정 심화2] (0) | 2021.02.24 |
| [Photo 공정 심화1] (0) | 2021.02.24 |



